联系方式
0769-83699986
135-3754-4550(朱先生)
在通讯网络设备中,导热材料的应用方案需根据设备功耗、热流密度、结构设计及成本等因素综合制定,以下是具体应用方案及分析:
一、低功耗设备(如5G小基站、路由器)
应用场景:设备功耗较低(<50W),热流密度<0.5W/cm²,散热需求以自然对流或低风速风冷为主。
推荐材料:
导热硅胶片
优势:导热系数0.8-3.0W/(m·K),可填补散热器与芯片间的微小间隙(0.1-5mm),降低接触热阻;具备绝缘、减震、防潮性能,适合复杂表面贴合。家庭级路由器CPU散热中,导热硅胶片替代失效材料后,CPU温度下降15℃,网络性能稳定性提升30%。
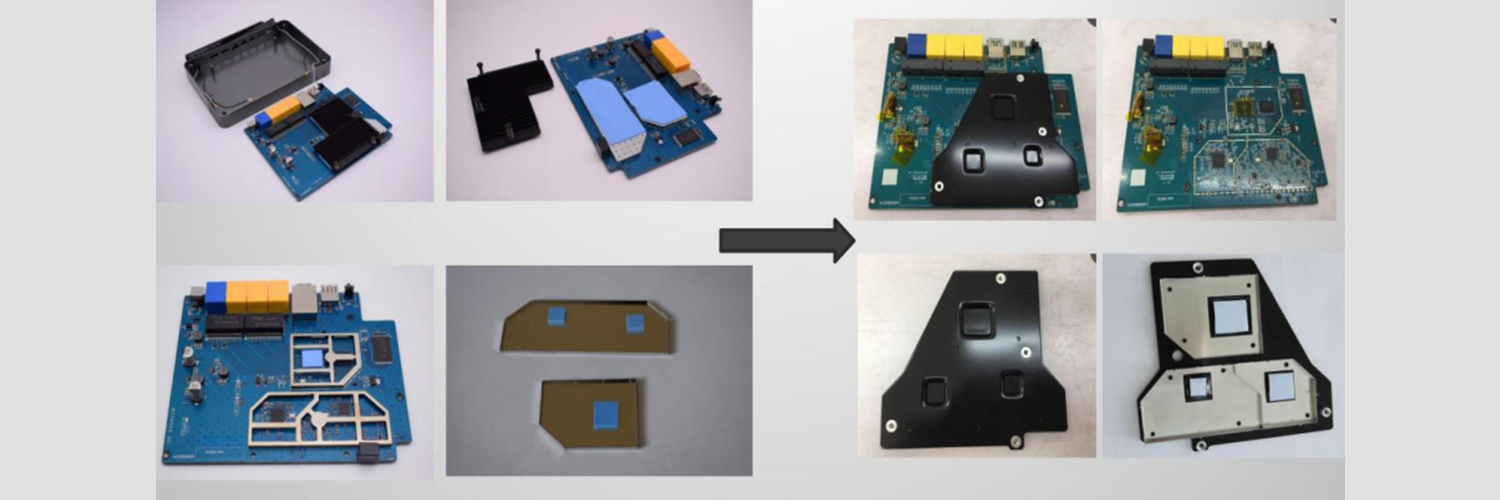
(路由器导热硅胶片+整体金属壳体热管理方案)
导热凝胶
优势:可压缩至0.1mm厚度,适合狭小空间填充,如芯片与屏蔽罩间的导热。
案例:手机无线充电模块中,导热凝胶填充PCB与散热后盖间隙,导热率老化后仅下降5%,同时保护PCB免受震动损伤。
二、中高功耗设备(如5G宏基站、核心网设备)
应用场景:设备功耗50-200W,热流密度0.5-5W/cm²,需强制风冷或液冷辅助散热。
推荐材料:
高导热凝胶
优势:可压缩至0.1mm厚度,热阻低至0.08-0.3℃·in²/W,能完全填充不平整表面(如芯片与散热器、相变导热界面材料间的微小缝隙),构建连续高效热传导通道,消除热斑效应。
相变导热界面材料(PCMI)
优势:常温下为固体,受热后相变为液态,填充微孔隙,热阻低至0.01°C·cm²/W;适合高性能处理器、电源模块等场景。5G基站AAU模块中,PCMI替代传统硅脂后,芯片温度降低10℃,功耗下降8%。
三、高功耗设备(如数据中心服务器、企业级网络设备)
应用场景:设备功耗>200W,热流密度>5W/cm²,需液冷或两相流散热技术。
推荐材料:
高导热凝胶
AAU模块应用解析:在AAU模块中,导热凝胶替代传统硅脂,填充芯片与散热器间隙,降低接触热阻,使芯片温度下降10℃,功耗降低8%。
数据中心服务器应用解析:数据中心服务器高密度计算导致局部热点,需高效散热保障稳定性。在CPU与散热器间涂抹导热凝胶,结合风冷或液冷系统,降低设备故障率20-30%,提高数据传输可靠性。
企业级网路设备应用解析:企业级网络交换机与路由器长时间高负荷运行,需稳定散热防止通信质量下降。在内存模块与散热片间填充导热凝胶,确保热量快速导出,避免因过热导致的数据丢包或延迟。

(导热硅胶片、导热凝胶在企业级网络设备中算力芯片应用)
具体应用场景 | 热管理方案材料应用 | 应用部件解析 |
低功耗设备(如5G小基站、路由器) | 导热硅胶片、导热凝胶
| 处理芯片与散热器间 |
中高功耗设备(如5G宏基站、核心网设备) | 高导热凝胶、相变导热界面材料
| 芯片与散热器、相变导热界面材料、微型热管间的微小缝隙 |
高功耗设备(如数据中心服务器、企业级网络设备) | 高导热凝胶 | AAU模块填充芯片与散热器间隙 |